SET 半導體覆晶技術 Flip-Chip
SET(Smart Equipment Technology)是全球領先的高精度覆晶接合設備(Flip-Chip Bonders)及多功能奈米壓印光刻(NIL)解決方案供應商。 自1975年以來一直致力於設計和製造專注於高精度應用的半導體設備。
SET 致力於為高精度及高可靠性的半導體實驗室和產業提供服務,幫助客戶組裝元件。 SET在全球安裝了眾多覆晶接合設備,以其無與倫比的次微米精度和設備的靈活性而享譽國際。
從手動裝載到全自動化版本,SET 的覆晶設備涵蓋了廣泛的黏著應用,並且能獨特地處理和接合易碎及小型元件至最大達 300 mm 的基板上。
什麼是覆晶技術 Flip-Chip bonding ?
覆晶接合是從機械和電學方個方面,將晶片組裝置基板的互連技術。通常尺寸較小的芯片會至於上方。通過翻轉、對準、然後接合到基板上。

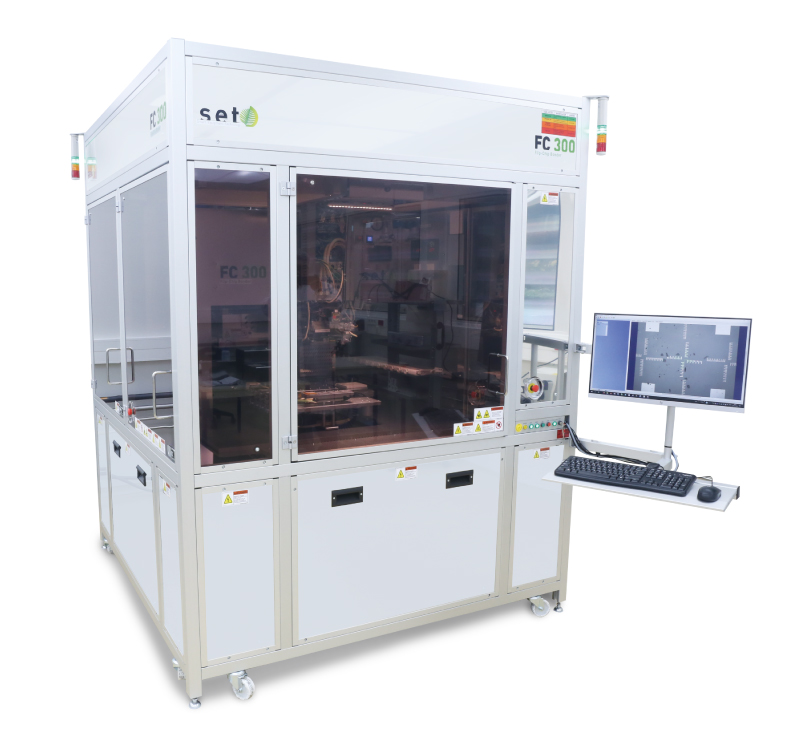
FC300 是最新一代高精度和高壓力的晶圓黏著設備,適用於直徑達 300 mm的晶圓。該系統還具有奈米壓印功能。FC300 能在同一平台上進行各種應用,並能快速重新配置工藝頭:
-
高壓力接合,特別適用於銅對銅(Cu-Cu)接合,可應用於 3D-IC 封裝或使用熱壓印微影製程的奈米壓印。
-
低壓力回流接合,用於射頻(RF)和光電子元件的組裝。
-
UV固化,用於黏著劑接合或使用 UV-NIL 製程的奈米壓印。
相關產品
-
/ 產品規格 /FC300是一款高精度、高壓力的覆晶接合機,適用於晶片對晶片 (最大100毫米)和晶片對晶圓(最大300 mm) 的應用。FC300 有著從 1 到 4000 N的大範圍接合力...